Growth and Fabrication:
Characterization:
|
1. Physical properties measurement system 2. Magnetic properties measurement system 3. Hall measurement system 4. Closed-cycle cryostat 5. Probe station 6. Mini-SEM 7. Mini-XRD 8. Optical microscope |
Growth and Fabrication:

Specification:
1. Chamber : Main (< 5 x10^-9 Torr, up to 800 ºC, 6 gun ports), Loadlock (< 1 x10^-8 Torr)
2. Automatic pressure control unit
3. DC Power supply : Max 1000 W, CW CV CC control
Manual:
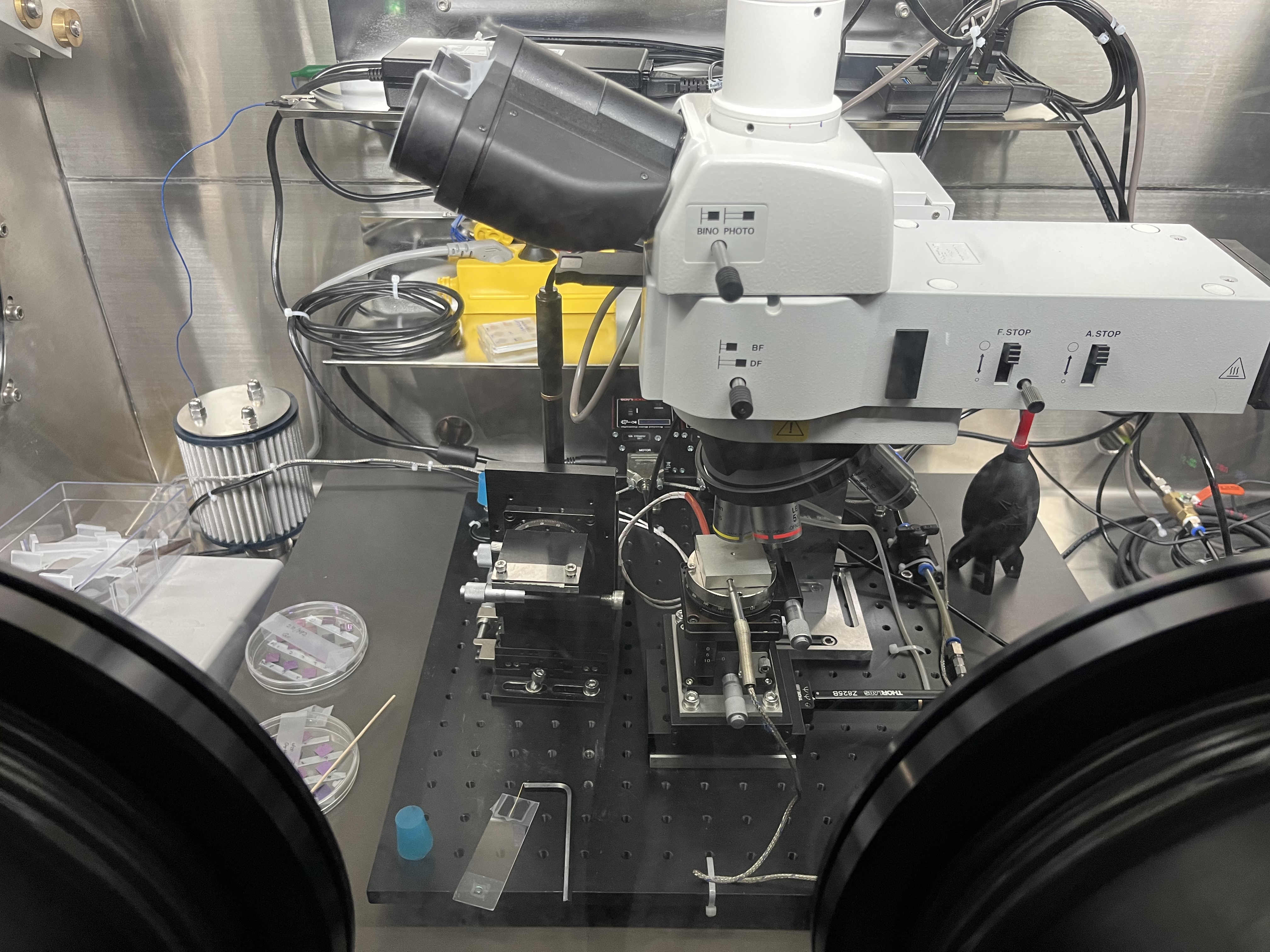
Specification:
1. Optical microscope (Nikon) : DS-Ri2 (Camera), Objective lens (5x, 10x, 20x, 50x, 100x), LED Lamphouse
2. XYZ stage : 8-axis manual & motorized linear stage, motorized linear stage
(resolution : 0.05 µm, range : 25 mm, 3-axis), heat up to 200 ºC
3. Active Vibration Isolation System (DVIA-T67, DAEIL SYSTEMS)
4. Conditions : O2, H2O < 1 ppm in Ar-filled glove box
Manual:
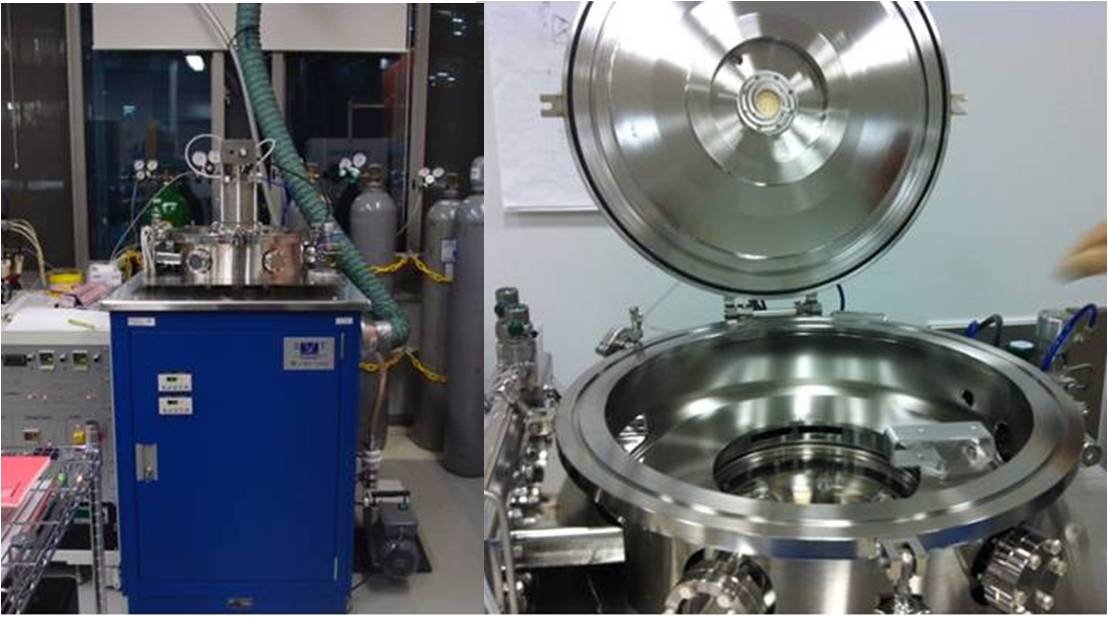
Atomic layer deposition: Tutorial, Animation
Specification:
1. Chamber: colsed coupled sample heater up to 500 C, QCM monitor
2. Gas delivery line: 2 carrier gas lines, 3. Precusor cells(2 with temperature control), plasma source line
4. Software control: Robo ALD process control
Manual:
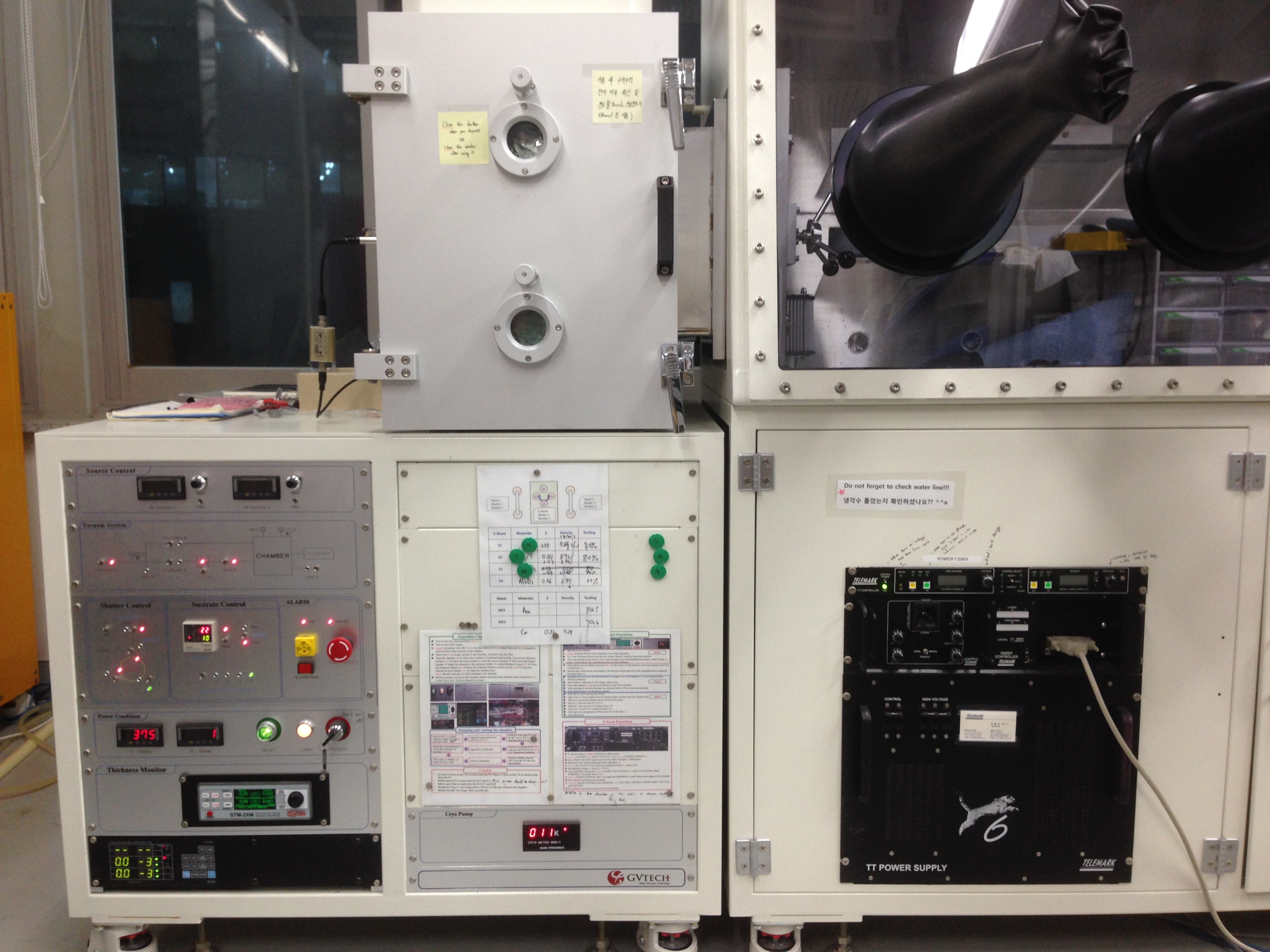
Specification:
2 thermal sources, 1 e-beam source (6kW, 7cc multi pocket), LN2 trap for substrate holder
Manual:
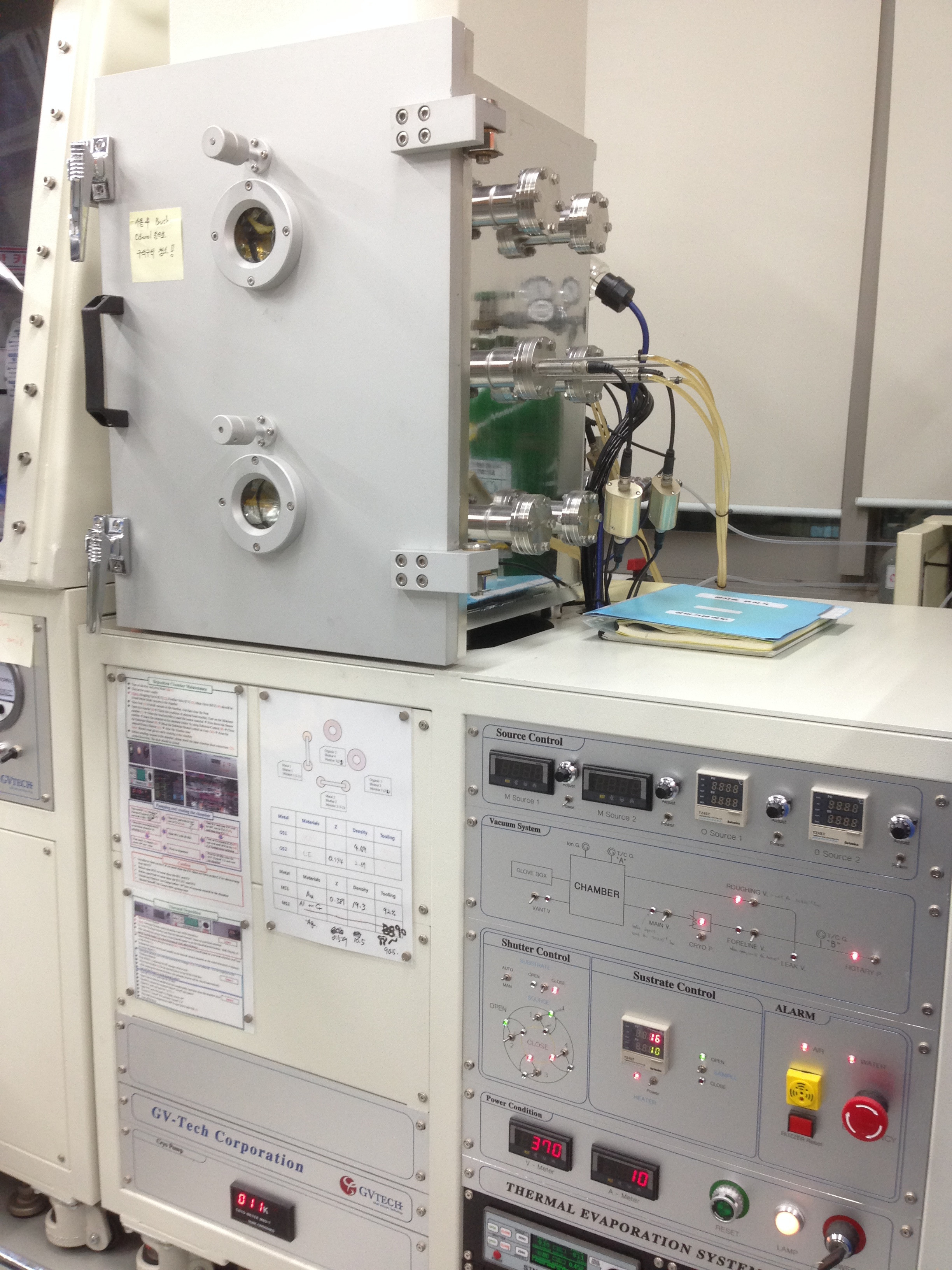
Specification:
3 temperature controllable organic source, 1 thermal sources, LN2 trap for substrate holder
Manual:
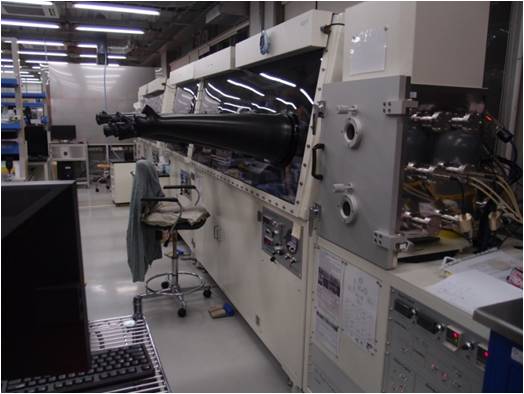
Specification:
1. Organic process chamber unit Features: 3 temperature controllable organic source, 1 metal sources, LN2 trap for substrate holder
2. Metal process chamber unit Features: 2 metal sources, 1 e-beam source (6kW, 7cc multi pocket)
3. 2 Glove box units with T-antichamber connection
Manual:

Specification:
1. Microwave power (2.45GHz, 50W/m2)
2. Gas: O2, Ar
3. Stage: 8 inch size

Specification:
Manual:
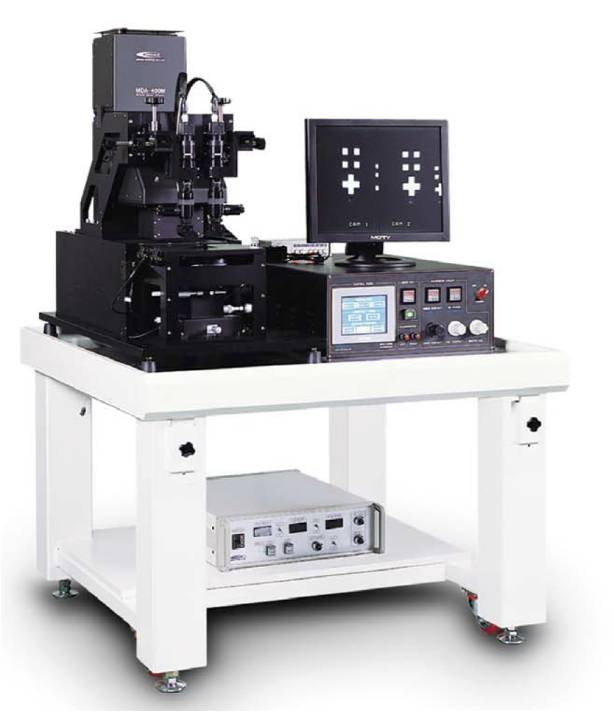
Specification:
1. Up to 6inch
2. UV lamp : Hg 350W
3. Wavelength : 350 ~ 450nm(I, H, G-line)
4. Lamp uniformity : ≤ 3%
3. Dual microscope(90X ~ 500X)
Manual:
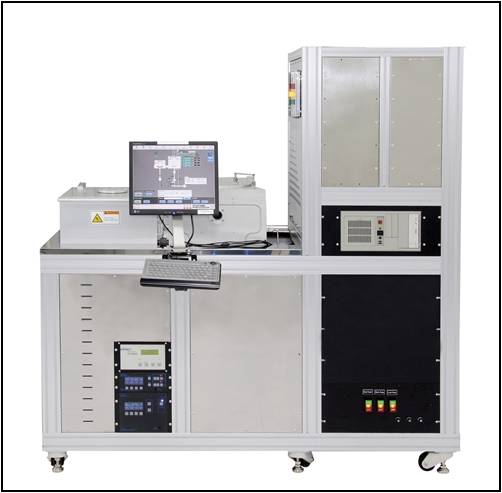
Specification:
1. Etch Rate: 1000 - 3000 Å/min
2. Selectivity: ≤ 2±0.5:1 SiN:PR
3. Uniformity: ≤ ±3.0 %
4. RF Power: 600W
5. Selectivity:SiO2:Resist = 3~5 : 1 (Resist dependent)
Manual:
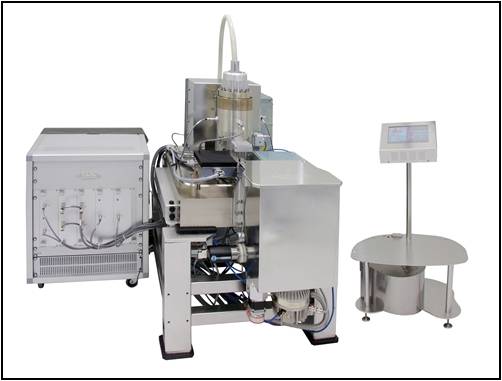
Specification:
1.Theoretical beam size : 2.1 nm for 100 keV, 7 nA
2. Line width : ≤ 5 nm
3. Deflection : vector scan, 55 MHz
4. Address grid resolution : 1 nm, 1 mm main field
5. Beam voltage : 30 ~ 100 keV
6. Writing area : 195 mm x 195 mm
7. Substrate size : 5 ~ 200 mm
8. Automation : 10 chucks automatic loading
9. Repeatable : 20 nm over wafer
Manual:
Characterization:

Specification:
1. Temperature Range : 1.9 K - 400 K
- Cryogen-free cooling technology.
- Continuous low-temperature control
- Controlled temperature sweep mode)
- Temperature accuracy : ±0.5 %
- Temperature stability : 0.2 % for T ≤10 K, 0.02 % for T > 10K
2. Magnet & Uniformity
- Magnet range : ±9 T (90,000 Gauss)
- Field resolution : 0.3 Oe to 1 T: 3 Oe to 9 T
- Slew Rate : Up to 200 Oe/sec
3. Elecrical Transport Option (ETO)
- Current Source Specifications: Current Range (10 nA to 100 mA), Frequency Range (DC, and 0.1Hz to 200 Hz AC)
- Resistance Specifications: Absolute Accuracy (0.1% for R < 200 kOhms), Relative Sensitivity (±10 nOhms RMS)
- Resistivity Range: 4uOhms to ~10 MOhms in 4-wire mode, 1 MOhms to ~5 GOhms in 2-wire mode (typical)
4. Vibrating Sample Magnetometer
- Geometry: Magnetic field II vibration and first order gradiometer coils, Coil-set bore (6.3 mm)
- Sample holders provided:
Tube (inner diameter = 3.2 mm; outer diameter = 4.8 mm)
Paddle (diameter = 3.2 mm), coil-set baseline (9 mm)
- VSM measurement parameters:
VSM oscillation frequency (calibrate): 40 Hz
VSM oscillation amplitude(typical): range of 0.5 mm - 10 mm peak-peak (typically 4 mm peak-peak)
- Sensitivity using the above typical parameters
Sensitivity : 2X10-6 emu/tesla with 1sec. averaging (typical)
Largest measurable moment : ∼150 emu (40 Hz, 1 mm p-p)
- VSM oven upto 1000 K
5. Thermal Transport System
- Thermal Conductivity κ
- Seebeck coefficient S
- Thermoelectric figure of merit ZT
6. Heat Capacity
- Temperature Range : 1.9 K - 400 K
- Sample Size: 1 - 500 mg(20 mg, typ.)
- Heat Capacity Resolution: 10 nJ/K at 2 K
- Measurement Accuracy: < 5%, 2 - 300 K < 2%, typ.
7. External electronics
- Keithley 2636 Duel channel sourcemeter
- Keithley 2400 Sourcemeter
- Keithley 2182A Nanovoltmeter
- Keithley 6221 AC/DC current source
- SR830 Lock-in amplifier
- SR310 High voltage
- 9x9 Matrix system
- AFG31101 Arbitrary Function Generator
- F10A High voltage linear amplifier
Manual:

Specification:
1. Temperature Range : 1.9 K - 400 K
- Cryogen-free cooling technology.
- Continuous low-temperature control
- Controlled temperature sweep mode)
- Temperature accuracy : ±0.5 %
- Temperature stability : 0.2 % for T ≤10 K, 0.02 % for T > 10K
2. Magnet & Uniformity
- Magnet range : ±9 T (90,000 Gauss)
- Field resolution : 0.3 Oe to 1 T: 3 Oe to 9 T
- Slew Rate : Up to 200 Oe/sec
Manual:
Specification:
Manual:
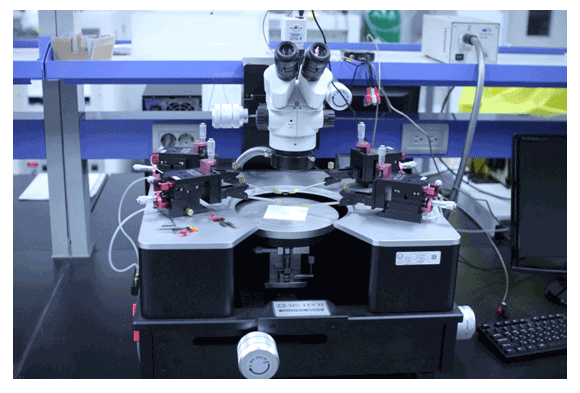
Specification:
Manual:

Specification:
Manual: